Увеличьте интегральную плотность печатной платы за счет заполнения глухих микропереходов и сквозных отверстий с помощью электролитического осаждения меди..
Постепенная миниатюризация электронных схем все чаще требует использования печатных плат HDI с заполненными медью глухими микропереходами.. Недавно разработанный медный электролит, который в настоящее время проходит испытания в производственных условиях, обеспечивает бездефектное заполнение глухих микропереходов с небольшой толщиной слоя меди на поверхности печатной платы. Разрабатываемый медный электролит также должен обеспечивать надежное заполнение сквозных отверстий в будущем. – текущие разработки уже дают многообещающие результаты.
Заполнение глухих микропереходов и сквозных отверстий


Повышение плотности упаковки печатных плат за счет заполнения глухих микропереходов и сквозных отверстий электроосаждением меди.
Увеличивающаяся миниатюризация электронных схем заставляет использовать Печатная плата HDI (Печатные платы HDI) с заполненными медью глухими микроотверстиями, все более желательно. Недавно разработанный медный электролит, в настоящее время проходят испытания в смоделированных производственных условиях, обеспечит бездефектное заполнение глухих микроотверстий, в то же время уменьшив толщину отложений меди на поверхности платы. Это приводит к более эффективному использованию материалов и, следовательно, к снижению стоимости производства печатных плат.. Другой медный электролит, который сейчас находится в стадии разработки, обещает обеспечить надежное заполнение сквозных отверстий..
1 Вступление
В микроэлектронике, сохраняется тенденция к миниатюризации, это, к меньшим и более мощным системам, которые также должны быть менее дорогими, чем предыдущие системы. Самыми известными примерами этого являются смартфоны и планшеты., исполнение которого – несмотря на такой же или даже меньший размер устройства – значительно увеличился за последние годы.
Печатные платы HDI (HDI: Межсоединение высокой плотности) внести значительный вклад в миниатюризацию. Для электрического соединения отдельных слоев печатной платы, компактные глухие отверстия (слепые микропереходы) используются вместо сквозных отверстий. Плотность интеграции может быть увеличена за счет заполнения глухих микропереходов электролитически осажденной медью. (слепое заполнение микроперехода). В это время, использование печатных плат HDI больше не ограничивается мобильной электроникой, но также все чаще используется в других приложениях, например в автомобильном секторе.
Недавно разработанный электролит, который в Blind Microvia Filling оставляет лишь очень малую толщину слоя меди по сравнению с предыдущим поколением электролитов., позволяет ресурсу, энергоэффективное и экономичное производство печатных плат HDI.
Поскольку плотность интеграции печатных плат HDI может быть увеличена еще больше за счет использования очень тонких материалов сердечника., разработка электролитов для заполнения сквозных отверстий (английский: Заполнение сквозных отверстий) в настоящее время укрепляется. Представлены результаты опытно-конструкторских работ в этом направлении..
2 Миниатюризация в области микроэлектроники
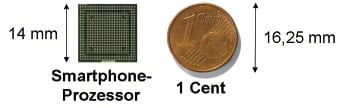
Самыми известными представителями прогрессивной миниатюризации в микроэлектронике являются очень мощные мобильные устройства, такие как смартфоны и планшеты.. Высокие и постоянно растущие показатели продаж отражают большую привлекательность этих устройств.. В 2013, больше, чем 1 миллиарда смартфонов было продано впервые, продажи около 1.2 миллиардов ожидается в 2014 и вокруг 1.8 миллиард в 2017 [2]. В области планшетных ПК, продажи 271 миллиона устройств прогнозируется на 2014, что соответствует увеличению почти на 40% по сравнению с предыдущим годом [3].
Они устанавливаются в процессоры с очень маленькими размерами корпуса и очень большим количеством соединений, которые становятся все более похожими на сеть.. На нижней стороне процессора есть 976 соединений на площади чуть менее 2 см², это соответствует примерно пяти соединениям на квадратный миллиметр.. Шаг соединений только 400 мкм.
3 Миниатюризация в области печатных плат
Печатные платы с соответственно высокой плотностью интеграции необходимы для компактного и надежного электрического соединения процессоров с чрезвычайно высокой плотностью соединений.. Классическая многослойная печатная плата для этого не подходит, тем не мение, поскольку в нем используются сквозные отверстия для электрического соединения отдельных слоев печатной платы. Они имеют относительно большой диаметр и, так как они просверливаются только после того, как отдельные слои были прижаты, они проходят по всей толщине печатной платы. Следствием этого является то, что даже при соединении непосредственно соседних слоев, пространство над и под фактическим соединением теряется и поэтому не может быть использовано для других конструкций, например кондукторные дорожки. В результате низкая плотность интеграции многослойных печатных плат недостаточна для требований, описанных выше..
Несколько лет назад, новый, высокоинтегрированное поколение печатных плат, так называемая печатная плата HDI, поэтому был разработан, который изначально использовался в основном для производства мобильных телефонов. При производстве печатных плат HDI, отдельные слои печатной платы наращиваются последовательно (СБУ, Последовательное наращивание). Электрическое соединение смежных монтажных позиций реализовано с помощью лазерно просверленных глухих микропереходов.. Фигура 2 схематично показывает структуру 2-4-2 Печатная плата HDI, т.е.. Печатная плата состоит из четырехслойного многослойного сердечника и двух слоев с каждой стороны.
4 Слепой микропереход
По сравнению со сквозными отверстиями, глухие микропереходы имеют меньшие диаметры в диапазоне от 50 Том 150 мкм, и они проходят только в направлении z по толщине монтажного положения. (как правило 50 Том 150 мкм). Они занимают ровно столько места, сколько фактически требуется для фактического подключения.. Таким образом, печатные платы HDI имеют гораздо более высокую плотность интеграции, чем многослойные печатные платы, и поэтому подходят для разделения сигналов высокофункциональных электронных компонентов в минимальном пространстве..
4.1 Заполнение слепых микропереходов
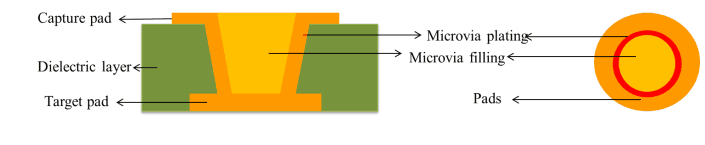
Дальнейшее увеличение плотности интеграции позволяет устанавливать в стопку глухие микропереходы. (сложенные слепые микропереходы). Если электролитически осажденная медь используется для заливки вместо токопроводящей пасты, это приводит к следующим дополнительным преимуществам:
Повышенная надежность (слепые микропереходы содержат только медь, нет дополнительного интерфейса)
лучшее управление теплом (потеря тепла может быть отведена через высокотеплопроводные, глухие микропереходы с медным наполнением)
Дальнейшее увеличение плотности интеграции (без дополнительных колодок (колодки) необходимы на поверхности печатной платы для контакта с компонентами)
Основные этапы процесса изготовления печатных плат HDI с заполненными медью глухими микропереходами схематически показаны на рисунке. 4. Если нужно построить еще один слой, последовательность процесса должна быть повторена снова, начиная с шага процесса 2.
Установка заполненных медью глухих микропереходов друг на друга означает, что даже несмежные монтажные позиции могут быть соединены электропроводящим способом с минимальными требованиями к пространству. (Рисунок. 5). Использование конструкций «переходное отверстие» или «переходное отверстие в колодке» приводит к дальнейшему увеличению плотности интеграции., поскольку соединения компонентов могут быть припаяны непосредственно к заполненным медью глухим микропереходам, так что не требуются дополнительные соединительные поверхности (Рисунок. 6).
4.2 Предыдущие электролиты для заполнения слепых микропереходов
Обычно, электролиты для заполнения слепых микропереходов содержат относительно высокую концентрацию ионов меди в диапазоне от 40 грамм / я к 60 грамм / л в сочетании с низкой концентрацией серной кислоты в диапазоне от 10 мл / я к 50 мл / л, а также хлорид-ионы. Добавки к органическому электролиту, необходимые для контроля свойств покрытия, различаются от специализированной компании к специализированной компании., но в основном в добавках к электролиту содержатся следующие три компонента:
Базовая добавка (ингибитор)
Зерновой рафинер (Активатор)
Выравниватель (ингибитор)
Кроме того, методы разных провайдеров также могут отличаться следующими особенностями:
Системные технологии (стандартная вертикальная система, вертикальная непрерывная система, горизонтальная непрерывная система)
Тип анода (медный анод, нерастворимый анод)
Текущая форма (постоянный ток, импульсный ток, обратный импульсный ток)
применимая плотность тока
Методы, ранее предложенные Schlötter для заполнения слепых микропереходов, работают исключительно с постоянным током в стандартных вертикальных системах или вертикальных непрерывных системах..
В первые годы слепого пломбирования микропереходов, По существу, были следующие дополнительные требования в дополнение к стандартным требованиям для электролитически осажденных медных покрытий для печатных плат (например. пластичность, надежность):
бездефектное заполнение глухих микропереходов без включений электролита
Минимальный уровень заполнения или максимально допустимое углубление (вмятина.
В процессе наполнения, 93 мкм медь (B) был помещен в слепой микропереход, в то время как толщина слоя на поверхности составляет всего 22 мкм (C), приводя к следующим показателям:
Отступ (А-Б): 30.4 мкм
Степень наполнения (B / А): 75%
Распределение металлов (B / C): 426%
В первую очередь это связано с принципом действия выравнивателя., благодаря чему медь осаждается не на поверхности, а в глухих микропереходах., т.е.. в областях с низкой плотностью тока и низким электролитным обменом.
Для достижения хорошего результата наполнения, добавки к электролиту должны быть очень хорошо скоординированы. На рисунке 8а показан слепой микропереход перед процессом розлива, а также различные результаты., что может произойти только при изменении добавок к электролиту. – при прочих равных параметрах разделения (Рисунок. 8быть).
4.3 Новый электролит для заполнения слепых микропереходов
Плотность интеграции печатных плат может быть увеличена еще больше за счет уменьшения ширины дорожек и расстояния между ними.. Для травления таких тонких проводников, тем не мение, толщина слоя меди на поверхности должна быть небольшой, поскольку в противном случае могут возникнуть серьезные подрезы и проблемы с поперечным сечением проводника.
Как показано на рисунке 4, толщина слоя меди может быть уменьшена после заполнения – возможно повторяется – прореживание меди, но для этого необходимы дополнительные этапы процесса и системы.. Кроме того, медь утонение меди, которая была ранее нанесена, частично удаляется, что негативно сказывается на ресурсе, энергоэффективность и экономическая эффективность при производстве печатных плат. Чтобы полностью избежать – или хотя бы уменьшить – прореживание меди, в дополнение к уже упомянутым требованиям, в последние годы было добавлено требование наносить медный слой минимально возможной толщины в процессе заполнения..
50-70 мг / л.хлорида
3–10 мл / l дополнительный слотокуп SF 31
0.2–1,0 мл / l дополнительный слотокуп SF 32
0.2–2,0 мл / l дополнительный слотокуп SF 33
Электролит работает при плотностях тока не более 2 А / дм² в диапазоне температур от 18 ° C и 22 ° C.
По сравнению с предыдущим поколением электролитов, толщина медного слоя, нанесенного на поверхность, может быть значительно уменьшена. Об этом свидетельствует распределение металла, который в показанных лабораторных испытаниях имеет чрезвычайно высокое значение более 2000% (Рисунок. 9б).
SF слот 30 в настоящее время проходит испытания в сотрудничестве с тайваньским партнером Schlötter AGES в Центре разработки печатных плат в Тайбэе, открытом в 2012 в производственных условиях в 7200 литровая вертикальная непрерывная система (Рисунок. 10).
Углубление: 7.0 мкм
Степень наполнения: 91%
Распределение металлов: 740%
На рисунке 11b показан другой слепой микропереходник с медным наполнением., который находится на той же печатной плате, что и Blind Microvia на рисунке 11a.. Примечательно, что, несмотря на неоптимальную геометрию BMV, результат наполнения очень хороший.
Slotocup SF 30 также обеспечивает бездефектное заполнение близко расположенных глухих микропереходов при небольшой толщине слоя медных поверхностей.. 12: SF слот 30 результаты тестов при заполнении близко расположенных слепых микропереходов
Очень плоские слепые микропереходы, которые возникают при использовании очень тонких диэлектриков, также можно без дефектов заливать новый электролит, но это приводит к несколько большей толщине слоя меди.
5 Заполнение сквозных отверстий
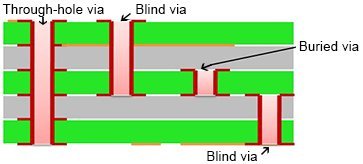
Дальнейшее увеличение плотности интеграции печатных плат HDI может быть достигнуто путем замены относительно толстых многослойных сердечников, которые использовались до сих пор, на значительно более тонкие сердечники с толщиной между 100 мкм и 200 мкм.
Очень тонкие сердечники могут иметь сквозные отверстия вместо глухих микропереходов.. Ранее, эти сквозные отверстия были сначала заполнены пастой после первого меднения, а затем снова покрыты медью для изготовления контактных площадок.. Кроме того, использование пасты может привести к проблемам с надежностью.
5.1 Новые электролиты для заливки сквозных отверстий
Первоначально, были предприняты попытки использовать уже опробованные и испытанные медные электролиты при заполнении глухих микропереходов в зоне заполнения сквозных отверстий.. тем не мение, Было показано, что эти электролиты не подходят для этого применения, поэтому необходимы дальнейшие разработки.. Некоторые лабораторные результаты текущих разработок показаны на рисунке. 16.
Изменяя состав электролита, удалось значительно улучшить заполнение сквозных отверстий (приблизительно. 85 мкм диаметр ствола скважины / приблизительно. 110 мкм глубина ствола скважины). Все четыре отложения, показанные на рисунке 16 проводились на постоянном токе с одинаковым временем напыления и плотностью тока.. Кроме того, только один электролит был нанесен за весь период осаждения, т.е.. замены электролита в процессе напыления не произошло.
С увеличением соотношения сторон, т.е.. уменьшение диаметра ствола скважины и / или увеличение глубины ствола скважины, массоперенос и, следовательно, последующая доставка ионов меди затрудняется. Как результат, бездефектное заполнение сквозных отверстий без включений электролита становится все труднее. Фигура 17 показаны два результата заполнения сквозных отверстий без предварительного усиления (приблизительно. 50 мкм диаметр ствола скважины / приблизительно. 160 мкм глубина ствола скважины).
Электролит, заключенный в дефекте (Рисунок. 17а) расширяется при нагревании печатной платы HDI и, следовательно, уже может привести к трещине в этом соединении во время пайки компонентов или при последующем повышении температуры, что может привести к сбою системы. В центре внимания текущих разработок:, следовательно, надежное бездефектное заполнение сквозных отверстий с различным соотношением сторон.
6 В заключении
Благодаря высокой плотности интеграции, Печатные платы HDI позволяют надежно разделить эти микропроцессоры с высокой плотностью соединений на минимальном пространстве..
Заполняя глухие микроотверстия электролитически осажденной медью., Плотность интеграции печатных плат HDI может быть дополнительно увеличена. Недавно разработанный электролит Slotocoup SF 30, который в настоящее время проходит испытания на Тайване в производственных условиях., обеспечивает бездефектное пломбирование при небольшой толщине слоя меди. Это приводит к дальнейшему увеличению плотности интеграции и большему ресурсу, энергоэффективное и экономичное производство печатных плат HDI. Первая установка у заказчика запланирована на второй квартал 2014.
Плотность интеграции можно еще больше увеличить с помощью так называемых структур без сердечника., которые состоят из очень тонких материалов сердечника. Результаты текущих опытно-конструкторских работ показывают, что осаждение меди постоянным током в принципе позволяет заполнить сквозные отверстия в этих сердечниках.. Поскольку результат заполнения и, следовательно, качество соединения зависит от соотношения сторон сквозных отверстий., реализация надежной бездефектной пломбы с различными соотношениями сторон в настоящее время находится на переднем плане разработок..




