BGA PCB 技術 有線ICに比べて多くの利点があります, といった:
•より小さな住宅
•より高いパッキング密度
•より高いピン密度
•改善された信号伝送特性
•回路基板へのより良い熱結合
これらのコンポーネントの最新の形式, VFBGAを有効にするなど (非常に細かいBGA) 一方、ピッチが0.5mm未満の数千の接続ピン.
BGA PCBコンポーネントは、対応するはんだ付けプロセスで組み立てられます, 多くの要因が関与している. このプロセスの結果は通常マットです.
•ボールと回路基板の間の高レベルの責任
•高い機械的長期安定性
•ボール本体の高い構造的完全性
•高い導電率
•高い電気信号の完全性
•隣接するピンに対する高い絶縁抵抗
この時点で、物理的状態と結果として生じる電気的特性の間の相互作用は明らかです.
参照モデルは、構造関係を簡略化して示しています. それは静的に基づいています, 単純なオームの指向性信号. チップに蔓延している条件 (ボンドワイヤ, 等) よく知られているように無視されています.
はんだ付けプロセス中の機械的レベルと電気的レベルの間の静的参照モデル, ボールのはんだははんだペーストと溶け、回路基板の表面と金属間化合物ゾーンと化学反応を起こします。. また, チップとボール本体の間に金属間化合物ゾーンがあります, これ, しかしながら, チップメーカーで発音されており、彼もチェックする必要があります. これは通常、送信機と受信機の間にあり、ミリオームレベルで安定している必要があります.
しかし、実際には系統的エラーとランダム エラーの両方が発生し、これらが電気的パラメータの大幅な変化につながり、1 つの光沢のあるはんだ接合部がエラーのないことを保証するものではないため、すべての理論は灰色です。. それらは、細いまたは太いはんだ接合の意味でのはんだ本体の目に見える変形にまで及びます。, 電気接点がある場所, 光学的に明確に定義されたはんだ接合まで, または散発的に落下する電気接点.
標準のIPC-A-610Eは、BGAPCBはんだ付けジョイントの役割の評価において重要な役割を果たします。. 電子アセンブリの受け入れ基準を指定し、BGA PCB コンポーネントの基準も指定します. したがって、生産システムでは、この規格へのはんだ接合の適合性が実証できることを保証するソリューションが必要です。. これにより、構造的に不安定なはんだ接合部が機械的ストレスを受けて破損し、電気伝導性の損失が回避されます。. しかしながら, 多くのエラーに注意する必要があります, はんだ体の形状, 極端な値でのみ電気的影響があります.
ここで言及する価値があるのは、「Head in Pillow」と「Black Pad」の既知の現象です。. 前者の効果で, はんだははんだペーストと溶けず、準バリア層が形成されます. しかしながら, はんだ接合部の光学系は、これを通常は明らかにしません. 主な原因, この場合, ボール表面の汚染です.
黒いパッドの問題は、回路基板にあります. ここでボールははんだペーストと反応しますが、その下には導電性が低下または完全に欠如した層も作成されます.
BGAPCBはんだ付け接合部の一般的なエラーカテゴリの概要
| 重大度 | 機械的 / オプティカル 外観 |
電気 外観 |
潜在的な 原因 |
| 故障 Lotkorpus |
球形が正しくない – 表面が正しくない – 毛穴 (ボイド) – 間違った位置 – はんだボールの距離が間違っている – 共面性の欠如 |
– RBKはほとんど変わりませんでした – RBK =∞ (接続を開く) – ボール間の短絡 |
– BGA-チップ (玉) – はんだペーストの品質 – はんだペースト塗布 – アセンブリオフセット – Lötprofil – パッドデザイン |
| 責任の弱さ ボールと 半田付け “枕に向かう” |
– 正しい球形 – 汚染層 ボールとはんだペーストの間 – 機械的なし 耐荷重能力 |
ライス=∞ (接続を開く) – 一時的な連絡 機械的負荷 |
BGA-チップ (玉) – はんだペーストの品質 – Lötprofil |
| 責任の弱さ はんだ接合間 および回路基板 “ブラックパッド” |
– 正しい球形 – 汚染層 ボールとはんだペーストの間 – 金属間化合物ゾーンの亀裂 – ダークパッドの変色 – 低機械的 レジリエンス (解体) |
– ライス=∞ (接続を開く) – 機械的ストレスにつながる 一時的な連絡のため – 正常範囲のRIZ, 接続が切断されます 負荷 (はんだ接合部を開く) |
– PCB品質 – はんだ付けプロファイル |
しかしながら, それらは解像度が低く、したがって金属間化合物ゾーンの責任の弱点の検出に問題があります. AXOIデバイスは、AXIとAOIを1つのシステムに統合します
また、回路基板に押し付けられた導体トラックが完全に埋め込まれた高密度 BGA アセンブリが原因で、正しく配置されていないチップの BGA PCB はんだ接合部が故障する可能性があります。.
ICTやFPTのような信頼できる方法を何年も脇に置いてください. 画期的な、いわゆるバウンダリスキャン法として, IEEE1149.xに基づくものは標準化されており、アダプターなしで動作します. 議論された生産要件から始めます, 複雑な BGA アセンブリの結晶化は、2 つの技術に焦点を当てています – AXIの形のX線システム / AXOIと電気試験装置バウンダリスキャンシステム. 両方の手順について、以下で詳しく説明します。.
X線技術が基本的にBGAを使用できる場合でも、X線の可能性を最大限に活用する. ボールを見ることは必要な技術的基礎にすぎません. 実際の顧客の利益は、主に技術的なデバイス設計によって定義されます.
X線システムは、完全自動X線検査のために、生産ライン内または生産ラインの隣で最新のSMD生産に使用されています。 (AXI) 中古. 要約すれば, BGAアセンブリのSMD生産ラインで使用するAXIシステムは、いくつかの基本的な基準を満たしています, といった:
•IPC-A-610Eに準拠した完全な検査
•低スリップ
•ゴーストエラーの発生率が低い (誤警報)
•生産ラインのビートレートの領域でのスループット (インライン操作)
•自動エラー検出
•簡単なプログラム生成
•直感的なユーザーガイダンス
•統計的プロセス制御のサポート (SPC)
IPC-A-610Eは、BGAPCBコンポーネントのはんだボールオフセットに関連する基準などの基準に対応しています, はんだボール距離, はんだボール形状, そして毛穴 (エアポケット) はんだ付けで.
トモシンセシスに基づくIPC-A-6103DAXIシステムの要件を満たすために特に効率的であることがチェックされます, 例えば. GÖPELelectronicのOptiConX-Line 3D.
統合されたAOIオプションを備えたOptiConX-Line 3D (AXOI)

よくはんだ付けされたBGAボール,
真円度OK
エリアOK
グレー値OK
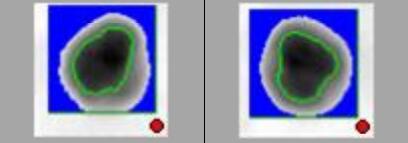
はんだ付け不良のボール
丸みNOK
エリアNOK
グレー値OK
はんだ接合の良し悪しの測定
図の例 3 ボールの例とそのボール画像処理評価を示す. 写真は、中央を通るセクションを示しています。 BGAはんだ付け ボール.
以下の例は、はんだの塗布量がボイド形成に影響を与えることを示しています。.

BGA – 50% はんだ量, 低排尿

BGA – 100% はんだ量, 低排尿, 軽くて大きなボールエリア

BGA – 200% はんだ量, 認識できる強い排尿
ボイドの表現
通常、, ボイドテストはボリュームを使用しません, しかし、ボイドエリアは確かに. 主にボイド領域はボール領域に関連しているため、発行されるボイド率は.
左下の例は、自動ボイド決定を示しています. はんだ接合全体のボイドの最大比率に対するIPC-A610Eの制限は次のとおりです。 25 パーセント.
BGA領域に対するボイド領域の比率の自動決定; 排尿= 27.4%; 測定面=ボールセンター

BGA領域に対するボイド領域の比率の自動決定; 排尿= 27.4%;
測定面=ボールセンター

2つのボール間の短絡; これらはまた電気テストによって検出することができます
ボイドコンポーネントの表現, 短絡, および非平面BGA
形状の評価に加えて, プレゼンス, とはんだボールの細孔, 図によると 5 はんだボール間の短絡も評価されます.
このBGAPCBに機械的または熱的ストレスがかかっている場合, 失敗することが予想されます. そのような傾斜した位置には、: BGAの下で静止するようになる漂遊コンポーネントが発生します.
のエラーシナリオ “枕元” 効果はすでに議論されています. 同義語でも知られています “トレーラー”. この障害シナリオを安全に再現可能にテストできるようにする1つの方法は、「ティアドロップ」パッド設計を使用することです。. これに関連して, BGAPCBの接続パッドは円形ではありません, でも涙の形.

ティアドロップデザインのBGAのX線画像; 丸い発音のはんだ付けはトレーラーです

ティアドロップデザインのBGAのX線画像; 丸い発音のはんだ付けはトレーラーです
ティアドロップ設計によるトレーラーの検出
ボールが溶けて下のはんだペーストと結合した場合, それは典型的な涙の形をしています. 接続が確立されていない場合, ボールは円形を保ち、真円度などの測定が可能です, 軸比またはボールが整理されている.
ティアドロップ形状により、2つのパッド間の距離が短くなり、最小電気絶縁距離が損なわれる可能性があります.
今, 多くの場合、ボールの形状の評価では、それを大きく変えるには不十分です. 片側にアセンブリがある場合, パッドとはんだボールの遷移を調べた高解像度2.5DX線斜め放射を使用できます。. ここでくびれが認識できる場合, これはトレーラーの表示です.
半自動BGA分析用のScopeLineMX-1000 (MXI)
針がない方がいいです
これは、複雑なBGAアセンブリのX線検査の補完的なパートナーです。バウンダリスキャン手順の最初の選択肢.
この設計統合されたテスト電子機器は、いわゆるテストバス駆動を介してシリアル化されます. 仮想針は実際にはバウンダリスキャンセルです, シフトレジスタの形式です (バウンダリスキャンレジスタ) 相互接続できます. BGAはんだ接合の電気的試験により、セルの問題の同期処理に成功します. しかしながら, 障害の場所は、方向接続を正確に決定するために使用することはできません, その後、MXIなどのプロセスが再度必要になります.
バウンダリスキャンによる2つのBGAピンの接続テスト
マルチポイント接続あり, 例えば. バスの構造, 一方, 完全に与えられたピンの正確な故障診断です. しかし、バウンダリスキャンプロセスの魅力は、プロトタイプをテストする際の高いテスト速度と柔軟性にもあります。.
ソフトウェアプラットフォームSYSTEMCASCON™などの高度なシステムソリューション [6] GÖPELエレクトロニックが提供する自動テストパターンジェネレーター (ATPG) 何千ものはんだ接合部を数秒で並行してテストし、自動ピンエラー診断を行うことができます, アダプターを必要とせずに. これ以上費用対効果が高くなることはほとんどありません。.
バウンダリスキャンは構造的なプロセスであり、チップ統合機能ロジックのプロセスとは独立しています。. 要するに、各ピンは個別であり、個別にテストできるということです。. これにより、プロセスが非常に使いやすくなります。. 気候チャンバー内の熱応力により、欠陥のあるはんだ接合が失敗する原因となる試みが行われます。. また、このGÖPEL電子製の組み立て済みハードウェアモジュールも提供しています, SCANFLEXシリーズのTIC03など.
しかし、バウンダリスキャンには実験室でもその強みがあります. 迅速なプロトタイプ検証のために、特定の信号の対象を絞ったチェックが設計者に関連することがよくあります. ここでは、ScanVision™などのグラフィックツールが最良の結果を達成します.
インタラクティブなピントグルのレイアウトと回路図の表現
レイアウトと回路図の間の相互参照だけでなく、対応するピンをクリックするだけでバウンダリスキャンセルをアクティブ化することもできます。.
結果として得られる論理信号の状態は、視覚化されたユーザー定義可能な配色から転送されます。.
バウンダリスキャンスタジオの導入には、PicoTAPDesignerなどの特別パッケージも利用できます。 [8] 利用可能なGÖPEL電子から. それらはすでにATPGとデバッガーを含むすべてのツールを含んでいます, すぐに開始するために必要なハードウェアと同様に.
これには、Iをテストするためのハードウェアモジュールも含まれます。 / O信号. これらのパッケージの特別な魅力は、もちろん非常に優れた価格/性能比です。.
完全なパッケージのコンポーネントPicoTAPDesigner Studio
これまでに説明したテクノロジーとシステムソリューションの存在自体が、最高の品質基準を備えた1つの製造には十分ではありません。. むしろ, BGAPCBアセンブリの製造におけるX線システムとバウンダリスキャンシステムの使用製造状況全体の徹底的な分析. とりわけ, 彼らは、戦うべきエラーとその統計的分布の権威ある役割について正確な知識を持っています. 全部で終わった 100 最適な検査およびテスト戦略に影響を与えることを定義するパラメーター. この点において, この時点で名前を付けることは不可能です “インクルード” 戦略. しかし、実際には、AXOIとBGAでのバウンダリスキャンの組み合わせにより、 100 パーセント誤差範囲は保証でき、BGAの比率が高いほど、これらの手法がより正確に重要になります。. 今日の観点から, それらは、視点から見た高密度アセンブリ用の唯一のソリューションです. そのような状況でのプロセスラインはどのように見えるかを見ることができます.
AXOIの使用例, BGAPCB組立ラインでのMXIとバウンダリスキャン
基本的な考え方は、各プロセスステップの背後にセンサーを確立し、フィードバックされたプロセスに関する統計的エラー情報を全体的に確立することです。. AXOIシステムは、検査速度が速いため、IPC-A-610Eおよび, 例えば, また、TQFPコンポーネントによって測定された内部メニスカス. 統合されたAOIシステムにより、まだ不足している機械的障害カバレッジが保証されます. MXIは精度分析のコミットメントに使用されます. 青で示されているセンサーはすべて、電子的に含まれているGÖPEL製品ポートフォリオに含まれています.
まとめと結論
BGAコンポーネントは、複雑な回路基板の重要なコンポーネントであり、これまで以上に高い集積密度と電気的パラメータの改善を可能にします. 継続的にアクセスが減少しているため、代替の検査およびテスト手順の形でより適切な対策を使用することが不可欠です.
実際には, 3D-AXOIマシン, 特に, 結合されたAXIを持っている / 最大の可能性のための電気的試験方法としてのAOIシステムとバウンダリスキャン
アクセスの問題を解決する. 両方の方法は互いに補完し合い、フォールトカバレッジを完全に可能にします 100% BGAはんだ付け継手用. また、IEEEのフレームワーク内で標準化が進むにつれて、バウンダリスキャンの基本的な将来のセキュリティも提供します。. GÖPELelectronicから開発された組み込みシステムアクセスの概念 (それ) これらの標準を含み、障害カバレッジを拡張するためのさらなるテクノロジーでそれらを補完します [11]. それにより、組み合わせはさらに魅力的になります.
議論されたシステムソリューションの最適な使用のために, しかしながら, そもそも、プロセスの状況を正確に分析することが不可欠です。バギーの花嫁が踊っていない場合は、すべてのテクノロジーをいじるのを助けたいからです。.