Tecnología PCB BGA tiene muchas ventajas sobre los circuitos integrados cableados, tal como:
• Vivienda más pequeña
• Mayor densidad de empaque
• Mayor densidad de pines
• Propiedades de transmisión de señal mejoradas
• Mejor acoplamiento térmico a la placa de circuito.
Últimas formas de estos componentes, como el que habilita VFBGA (Muy fina BGA) mientras tanto, varios miles de pines de conexión con un paso de menos de 0,5 mm.
Los componentes de PCB BGA se ensamblan en un proceso de soldadura correspondiente, con muchos factores que juegan un papel. El resultado de este proceso suele ser un mate.
• Alto nivel de responsabilidad entre la pelota y la placa de circuito.
• Alta estabilidad mecánica a largo plazo
• La alta integridad estructural del cuerpo de la bola
• Alta conductividad
• Alta integridad de la señal eléctrica
• Alta resistencia de aislamiento a los pines vecinos
En este punto, la interacción entre los estados físicos y las propiedades eléctricas resultantes es clara..
El modelo de referencia muestra las relaciones estructurales de forma simplificada. Se basa en una estática, señal direccional con óhmica simple. Las condiciones imperantes en el chip. (cables de enlace, etc.) son descuidados como bien conocidos.
Modelo de referencia estático entre el nivel mecánico y el eléctrico durante el proceso de soldadura., la soldadura de las bolas se derrite con la pasta de soldadura y forma una reacción química con la superficie de la placa de circuito una zona intermetálica. también, hay una zona intermetálica entre el chip y el cuerpo de la bola, cual, sin embargo, se pronuncia en el fabricante del chip y también debe ser verificado por él. Esto normalmente debe estar entre el transmisor y el receptor y debe ser estable en el nivel de miliohmios..
Pero toda la teoría es gris porque en la práctica ocurren errores tanto sistemáticos como aleatorios y estos conducen a parámetros eléctricos muy modificados. Además, una junta de soldadura brillante no es de ninguna manera una garantía de ausencia de errores.. Van desde deformaciones visibles del cuerpo de soldadura en el sentido de uniones de soldadura magras o grasas., donde hay contacto eléctrico, hasta uniones de soldadura ópticamente bien definidas sin, o contacto eléctrico que cae esporádicamente.
El estándar IPC-A-610E juega un papel importante en la evaluación del papel de una junta de soldadura de PCB BGA. Especifica los criterios de aceptación para ensamblajes electrónicos y también especifica los criterios para componentes de PCB BGA.. Entonces, para un sistema de producción, se necesitan soluciones que aseguren la conformidad de las uniones soldadas con este estándar.. Esto también provoca que se rompan las uniones de soldadura estructuralmente inestables donde están bajo tensión mecánica y, por lo tanto, se evita la pérdida de conductividad eléctrica.. sin embargo, Queda por notar que muchos errores, la forma del cuerpo de soldadura, solo tienen efectos eléctricos en valores extremos.
Vale la pena mencionar aquí los fenómenos conocidos "Head in Pillow" y "Black Pad".. Con el primer efecto, la soldadura no se derrite con la pasta de soldadura y se forma una capa de cuasi-barrera. sin embargo, la óptica de la junta de soldadura revela que esto normalmente no. Las principales causas, en este caso, son contaminación de la superficie de la bola.
El problema con la almohadilla negra es más hacia la placa de circuito.. Aquí la bola reacciona con la pasta de soldadura, pero debajo también crea una capa con una falta de conductividad reducida o completa..
Descripción general de las categorías de error típicas para juntas de soldadura de PCB BGA
| Gravedad | Mecánico / Óptico apariciones |
eléctrico apariciones |
potencial causas |
| Defectuoso Lotkorpus |
forma esférica incorrecta – superficie incorrecta – poros (vacíos) – Posición incorrecta – Distancia de la bola de soldadura incorrecta – falta de coplanaridad |
– RBK apenas cambió – RBK = ∞ (conexión abierta) – Cortocircuito entre bolas |
– Chip BGA (Bola) – Calidad de la pasta de soldadura – Aplicación de pasta de soldadura – Desplazamiento de ensamblaje – Lötprofil – Diseño de almohadilla |
| debilidad de responsabilidad entre pelota y pasta de soldadura “Cabeza en almohada” |
– forma esférica correcta – capa de contaminación entre bola y pasta de soldadura – No mecanico capacidad de carga |
ARROZ = ∞ (conexión abierta) – Contacto temporal a través de carga mecanica |
Chip BGA (Bola) – Calidad de la pasta de soldadura – Lötprofil |
| debilidad de responsabilidad entre junta de soldadura y placa de circuito “Almohadilla negra” |
– forma esférica correcta – capa de contaminación entre bola y pasta de soldadura – grietas en la zona intermetálica – Decoloración de la almohadilla oscura – baja mecanica Resiliencia (demolición) |
– ARROZ = ∞ (conexión abierta) – conduce a estrés mecánico para contacto temporal – RIZ en el rango normal, La conexión se interrumpe Carga (junta de soldadura abierta) |
– Calidad de PCB – perfil de soldadura |
sin embargo, Tienen una resolución más baja y, por lo tanto, problemas en la detección de debilidades de responsabilidad en las zonas intermetálicas.. Los dispositivos AXOI combinan AXI y AOI en un solo sistema
También son capaces de fallar en las juntas de soldadura de PCB BGA en chips colocados incorrectamente debido a los ensamblajes BGA de alta densidad con pistas conductoras completamente incrustadas en la placa de circuito que empuja contra ella..
Deje de lado métodos confiables como las TIC y FPT durante años. Como innovador el llamado método de escaneo de límites, que se basa en IEEE1149.x está estandarizado y funciona sin un adaptador. Partiendo de los requisitos de producción discutidos, la cristalización para conjuntos BGA complejos se centra en dos tecnologías – Sistemas de rayos X en forma de AXI / AXOI y un sistema de escaneo de límites de dispositivos de prueba eléctrica. Ambos procedimientos se examinan con más detalle a continuación..
Aproveche al máximo el potencial de los rayos X incluso si la tecnología de rayos X es básicamente capaz de utilizar el BGA. Mirar las pelotas es solo una base técnica necesaria. El beneficio real para el cliente se define principalmente por el diseño de dispositivos tecnológicos.
Los sistemas de rayos X se utilizan en la producción moderna de SMD, ya sea directamente en la línea de producción o junto a ella para una inspección por rayos X completamente automática. (AXI) usó. En resumen, Los sistemas AXI para su uso en líneas de producción SMD en ensamblajes BGA cumplen una serie de criterios básicos, tal como:
• Inspección completa según IPC-A-610E
• Deslizamiento bajo
• Baja tasa de errores fantasmas (alarmas falsas)
• Rendimiento en el área de la frecuencia de pulsación de la línea de producción (operación en línea)
• Detección automática de errores
• Generación de programas simple
• Orientación intuitiva para el usuario
• Soporte para el control de procesos estadísticos (SPC)
El IPC-A-610E aborda criterios como los relacionados con el desplazamiento de la bola de soldadura de los componentes de PCB BGA, distancia de la bola de soldadura, forma de bola de soldadura, y poros (bolsillos de aire) en la soldadura.
Particularmente eficiente para cumplir con los requisitos de los sistemas IPC-A-610 3D AXI basados en tomosíntesis se deben verificar, p. ej.. OptiCon X-Line 3D de GÖPEL electronic.
OptiCon X-Line 3D con opción AOI integrada (AXOI)

Bola BGA bien soldada,
Redondez OK
Área OK
Valor gris OK
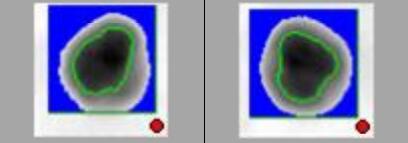
Bolas mal soldadas
Redondez NOK
Área NOK
Valor gris OK
Medición de uniones soldadas buenas y malas
Los ejemplos en la Figura 3 mostrar un ejemplo de una pelota y su evaluación del procesamiento de imágenes de la pelota. Las imágenes muestran la sección a través de la mitad de la Soldadura BGA pelotas.
El siguiente ejemplo muestra que la cantidad de soldadura aplicada influye en la formación de huecos..

BGA – 50% volumen de soldadura, baja evacuación

BGA – 100% volumen de soldadura, baja evacuación, área de bola más grande y ligera

BGA – 200% volumen de soldadura, fuerte micción reconocible
Representación de vacíos
Típicamente, la prueba de vacío no usa el volumen, pero el área del vacío ciertamente. Principalmente, el área de nulos está relacionada con el área de la pelota y, por lo tanto, el porcentaje de nulos emitido..
El ejemplo inferior izquierdo muestra la determinación automática de vacíos.. El límite de IPC-A610E para la proporción máxima de vacío en la junta de soldadura total es 25 por ciento.
Determinación automática de la proporción de área vacía a área BGA; Anular = 27.4%; Plano de medición = centro de la bola

Determinación automática de la proporción de área vacía a área BGA; Anular = 27.4%;
Plano de medición = centro de la bola

Cortocircuitos entre dos bolas; Estos también pueden detectarse mediante una prueba eléctrica.
Representación de componentes vacíos, Corto circuitos, y BGA no plano
Además de evaluar la forma, presencia, y poros de las bolas de soldadura, de acuerdo con la figura 5 también se evalúan los cortocircuitos entre las bolas de soldadura.
Si esta PCB BGA está sometida a tensión mecánica o térmica, se espera que falle. Tal posición inclinada puede incluir: Se provocan componentes extraviados que se detienen bajo el BGA.
El escenario de error del “cabeza-en-almohada” efecto ya ha sido discutido. También se conoce con el sinónimo “remolque”. Una forma de este escenario de falla de forma segura y para poder probar de manera reproducible es el uso de un diseño de almohadilla de "lágrima".. en esta conexión, las almohadillas de conexión de la PCB BGA no son circulares, pero en forma de lágrima.

Imagen de rayos X de un BGA con diseño de lágrima; la soldadura redonda pronunciada son remolques

Imagen de rayos X de un BGA con diseño de lágrima; la soldadura redonda pronunciada son remolques
Detección de remolques mediante diseño de lágrima
Si una bola se derrite y se combina con la pasta de soldadura debajo, tiene la forma típica de lágrima. Si no se establece ninguna conexión, la bola conserva su forma circular y se puede medir como redondez, la relación del eje o la bola se clasifican abe.
La forma de lágrima reduce la distancia entre dos almohadillas y puede causar lesiones a la distancia mínima de aislamiento eléctrico..
Ahora, una evaluación de la forma de la bola a menudo no es suficiente para diferenciarla. Si hay ensamblajes en un lado, Puede usar radiación oblicua de rayos X 2.5D de alta resolución examinó la transición entre la almohadilla y la bola de soldadura.. Si la constricción es reconocible aquí, esta es una indicación de un tráiler.
ScopeLine MX-1000 para análisis BGA semiautomático (MXI)
Es mejor sin agujas
Este es un socio complementario para la inspección por rayos X de ensamblajes BGA complejos.Primera elección del procedimiento de escaneo de límites..
Esta electrónica de prueba de diseño integrado se serializa a través de un llamado bus de prueba controlado. Las agujas virtuales son en realidad células de escaneo de límites., que están en forma de registro de desplazamiento (registro de escaneo de límites) se puede interconectar. Mediante la prueba eléctrica de juntas de soldadura BGA se logra el manejo sincrónico de los problemas de la celda. sin embargo, La ubicación de la falla no se puede utilizar para determinar exactamente las conexiones direccionales., entonces se requieren de nuevo procesos como MXI.
Prueba de conexión de dos pines BGA mediante escaneo de límites
Con conexiones multipunto, p. ej.. Estructuras de bus, por otra parte, es un diagnóstico de fallas exacto de pin completamente. Pero el encanto del proceso de escaneo de límites es también su alta velocidad de prueba y flexibilidad al probar prototipos..
Soluciones de sistema sofisticadas como la plataforma de software SYSTEM CASCON ™ [6] de GÖPEL electronic ofrecen generadores automáticos de patrones de prueba (ATPG) Que miles de pruebas de las juntas de soldadura en paralelo en unos segundos y con diagnóstico automático de error de pin pueden, sin necesidad de adaptador. Difícilmente puede ser más rentable.
El escaneo de límites es un proceso estructural e independiente de eso en la lógica funcional integrada del chip. La conclusión es que cada pin es individual y se puede probar de forma independiente. Esto también hace que el proceso sea muy fácil de usar combinar pruebas de estrés en las que,. debido al estrés térmico en una cámara climática, se intenta hacer que las juntas de soldadura defectuosas fallen. También ofrece para este GÖPEL módulos de hardware premontados electrónicos, como el TIC03 de la serie SCANFLEX.
Pero Boundary Scan también tiene sus puntos fuertes en el laboratorio.. Para la verificación rápida de prototipos, la verificación específica de ciertas señales suele ser relevante para el diseñador. Aquí las herramientas gráficas como Scan Vision ™ logran los mejores resultados.
Representación de diseño y esquema para alternar pines interactivos
No solo permiten la referencia cruzada entre el diseño y el esquema, sino también la activación de las celdas de escaneo de límites simplemente haciendo clic en el pin correspondiente..
Los estados de señales lógicas resultantes se transfieren desde los esquemas de color definibles por el usuario visualizados.
Paquetes especiales como PicoTAP Designer también están disponibles para la introducción de Boundary Scan studio [8] de GÖPEL electronic disponible. Ya contienen todas las herramientas, incluido ATPG y depurador., así como el hardware necesario para comenzar de inmediato.
Esto también incluye un módulo de hardware para probar I / O señales. El encanto especial de estos paquetes es, por supuesto, su excelente relación precio / rendimiento..
Componentes del paquete completo PicoTAP Designer Studio
La mera existencia de las tecnologías y soluciones de sistemas discutidas hasta ahora es suficiente para que una fabricación con los más altos estándares de calidad no sea suficiente.. Bastante, el uso de sistemas de rayos X y sistemas de escaneo de límites en la producción de ensamblajes de PCB BGA un análisis exhaustivo de toda la situación de fabricación. Sobre todo, Juegan con un conocimiento preciso de los errores que se deben combatir y su función de autoridad en la distribución estadística.. En total hay más 100 parámetros que definen una influencia en la estrategia óptima de inspección y prueba. A este respecto, en este punto es imposible nombrar “la” estrategia. Pero el hecho es que la combinación de AXOI y Boundary Scan en BGA proporciona 100 la cobertura de error porcentual puede garantizar y cuanto mayor es la proporción de BGA, más importantes son precisamente estas técnicas. Desde la perspectiva de hoy, son para montajes de alta densidad en perspectiva la única solución. Se puede ver cómo se ve una línea de proceso para tales situaciones.
Ejemplo de uso de AXOI, MXI y Boundary Scan en una línea de ensamblaje de PCB BGA
La idea básica es establecer un sensor detrás de cada paso del proceso y la información de error estadístico de manera integral en los procesos retroalimentados.. El sistema AXOI puede, debido a su alta velocidad de inspección, calificar el módulo de acuerdo con IPC-A-610E y, por ejemplo, también el menisco interno medido por los componentes de TQFP. La cobertura de fallas mecánicas que aún falta está asegurada por el sistema AOI integrado. MXI se utiliza para el compromiso de análisis de precisión. Los sensores que se muestran en azul están todos en la cartera de productos de GÖPEL electrónicos incluidos.
Resumen y conclusiones
Los componentes BGA son un componente importante de las placas de circuito complejas y permiten densidades de integración cada vez mayores y mejoras en los parámetros eléctricos.. El acceso continuamente decreciente hace que el uso de contramedidas más apropiadas en forma de procedimientos alternativos de inspección y prueba sean esenciales.
En la práctica, 3Máquinas D-AXOI, En particular, tener un AXI combinado / Sistema AOI y Boundary Scan como método de prueba eléctrica para el mayor potencial
Resuelve los problemas de acceso. Ambos métodos se complementan perfectamente y permiten la cobertura de fallas contra 100% para juntas de soldadura BGA. También ofrece seguridad futura fundamental de escaneo de límites a medida que avanza en la estandarización dentro del marco de la IEEE.. Que desde GÖPEL electronic el concepto desarrollado de acceso al sistema integrado (ESA) involucra estos estándares y los complementa con más tecnologías para extender la cobertura de fallas [11]. Por lo tanto, la combinación se vuelve aún más atractiva..
Para un uso óptimo de las soluciones de sistema discutidas, sin embargo, Hay uno en primer lugar, el análisis preciso de la situación del proceso es esencial porque si la novia con buggy no está bailando, quiere ayudar a toda la tecnología a tocar el violín..