Tableau de grille à billes (BGA) le packaging est devenu l'une des techniques les plus populaires pour les circuits intégrés nécessitant un nombre élevé d'entrées/sorties. Le conditionnement BGA offre des avantages par rapport aux autres méthodes grâce à sa capacité d'interconnexion haute densité. À mesure que la complexité des circuits intégrés augmente, avec une croissance incessante du nombre de broches et de portes, BGA apparaît comme une solution d'emballage optimale équilibrant coût et performances. Dans ce guide, nous expliquerons la soudure BGA – le processus de fixation des packages BGA aux cartes de circuits imprimés. Nous expliquerons comment fonctionne la soudure BGA, inspection des joints de soudure, et procédures de reprise. En comprenant le processus de soudage du Ball Grid Array, ses défis, et solutions, les fabricants peuvent utiliser efficacement cette technologie d'emballage avancée.
Qu'est-ce que BGA
BGA est un type unique d'emballage à montage en surface, qui est utilisé pour les circuits intégrés où l'électronique composants de CMS sont apposés et montés sur la surface de la carte de circuit imprimé SMT. BGA présente des conducteurs en forme de boule qui sont distribués dans des tableaux au bas de l’emballage. Et le réseau de billes tire en fait son nom du fait qu'il s'agit d'un réseau de billes en métal ou en alliage disposé dans une grille..
Forfaits BGA sont utilisés pour monter des appareils de manière permanente. Il a la capacité de fournir plus de broches d'interconnexion dans lesquelles vous pouvez mettre des packages plats ou doubles en ligne. Les broches utilisées dans cette technologie sont des billes de soudure disposées selon un motif (généralement un motif en forme de grille) sur la surface inférieure du colis. Ceci est fait pour augmenter la zone de connexions au lieu de simplement la périphérie. Le plus intéressant, avec soudure BGA, vous pouvez bénéficier de l'utilisation de toute la surface inférieure de l'appareil au lieu d'utiliser uniquement le périmètre.
Il s'agit d'une technique utilisée dans divers produits électroniques pour monter différents circuits intégrés tels que les FPGA., Puces Wi-Fi, et FPGA, etc. Encore plus, ces packages sont également utilisés dans les périphériques RAM, Chipsets PC, et microcontrôleurs.
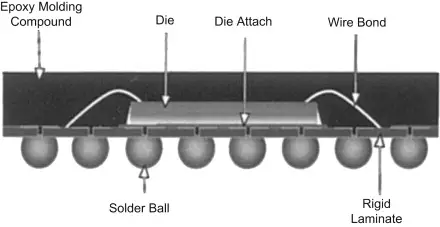
Comment fonctionne la soudure BGA
Premier, de la pâte à souder est appliquée sur le Plaquettes PCB où les billes de soudure BGA entreront en contact. La pâte à souder est généralement distribuée via un processus de pochoir ou de sérigraphie pour garantir une application précise et reproductible..
ensuite, le composant BGA est positionné avec précision et temporairement cloué en place sur le PCB. Cela se fait à l'aide d'un équipement de sélection et de placement doté de systèmes de contrôle de mouvement X-Y et d'alignement optique de haute précision.. Un bon alignement est essentiel.
ensuite, le PCBUNE est envoyé dans un four de refusion avec un profil de température défini. La pâte à souder fond, les billes de soudure du BGA fondent et fusionnent avec les plages du PCB, former les joints de soudure. Le profil doit être suffisamment chaud pour refusionner la soudure sans endommager les composants.
Durer, après refroidissement, les joints de soudure sont inspectés pour une formation correcte et sans défauts. Toute retouche nécessaire est effectuée à l'aide d'équipements et de procédures spécialisés de retouche BGA..
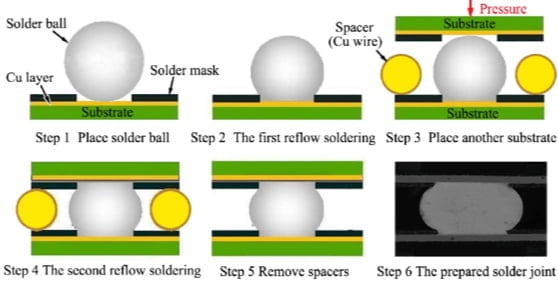
Inspection des joints de soudure BGA
Quand les packages de réseaux de grilles à billes ont été introduits pour la première fois, il y avait une incertitude sur la façon de vérifier les joints de soudure, puisqu'ils ne sont pas visibles sous le composant. Les méthodes d'inspection optique traditionnelles ne pouvaient pas être utilisées. Également, les tests électriques manquent de fiabilité car ils ne reflètent que la conductivité électrique du BGA au moment précis du test. Cette méthode ne parvient pas à anticiper la durabilité à long terme de la soudure, ce qui peut entraîner une défaillance du joint de soudure au fil du temps.
Pour véritablement inspecter les joints de soudure BGA, une technique d'imagerie aux rayons X était nécessaire. Les rayons X peuvent pénétrer dans le composant et capturer des images des joints cachés. Donc, L'inspection aux rayons X est devenue essentielle pour le contrôle des processus et l'assurance qualité lors de l'assemblage de cartes avec des BGA.. Contrôle aux rayons X fournit la confiance nécessaire en vérifiant que tous les joints sont entièrement et correctement formés. Avec radiographie, les fabricants peuvent valider leurs processus BGA et assurer la fiabilité à long terme exigée de ces interconnexions cachées.

Refonte BGA
Lorsqu'un composant de la grille à billes s'avère défectueux, un processus de retouche est nécessaire pour le retirer et le remplacer. Les joints de soudure doivent être soigneusement fondus sans perturber les composants voisins. Ceci est accompli à l'aide d'une station de reprise BGA, qui utilise une chaleur et un flux d'air ciblés.
Un préchauffeur infrarouge réchauffe doucement la carte par le bas pour minimiser les chocs thermiques. Un thermocouple surveille les températures en temps réel. Un outil à vide soulève le paquet BGA une fois refondu. Des contrôles stricts des processus sont essentiels au succès:
- Faites correspondre les alliages de soudure pour garantir la compatibilité des joints
- Équilibrer la force d'adhérence de l'adhésif pour les ajustements de positionnement
- Suivre de près les profils thermiques prescrits
- Utilisez le réglage de débit d'air minimum requis
- Augmentez lentement le BGA après la refusion, éviter de frotter
- Sélectionnez la taille de buse correspondant au composant
Avec de l'expérience et des procédures disciplinées, retravailler les BGA peut devenir fiable. Mais cela demande beaucoup de précision et de soin pour éviter les dommages collatéraux.. Des processus bien réglés, outils spécialisés, et les compétences de l'opérateur sont des facteurs clés pour obtenir des résultats de retouche BGA de qualité..
Dernières pensées
Implémentation d'une soudure BGA robuste, inspection, et les processus de reprise nécessitent des investissements dans des techniques spécialisées, équipement, et formation des opérateurs. Mais les avantages d'un emballage BGA à plus haute densité rendent cet effort rentable en termes de qualité et de performances.. Avec une expertise en impression de précision, placement précis, refusion profilée, examen aux rayons X, et retouche maîtrisée, des fabricants comme MOKO Technology permettent aux clients de tirer pleinement parti des BGA dans les applications critiques. En tant que principal fournisseur d'assemblages de PCB avec près de 20 des années d'expérience, MOKO se spécialise dans la technologie avancée de soudage Ball Grid Array. Nous contacter aujourd'hui pour discuter de votre projet BGA particulier et des exigences d'assemblage.