Matrice di griglie di sfere (BGA) il confezionamento è diventato una delle tecniche più popolari per i circuiti integrati che richiedono un elevato numero di input/output. Il packaging BGA offre vantaggi rispetto ad altri metodi grazie alla sua capacità di interconnessione ad alta densità. Con l'aumento della complessità del circuito integrato, con una crescita inarrestabile del numero di pin e di gate, BGA emerge come una soluzione di packaging ottimale che bilancia costi e prestazioni. In questa guida, spiegheremo la saldatura BGA – il processo di collegamento dei pacchetti BGA ai circuiti stampati. Tratteremo come funziona la saldatura BGA, ispezione dei giunti di saldatura, e procedure di rilavorazione. Comprendendo il processo di saldatura Ball Grid Array, le sue sfide, e soluzioni, i produttori possono utilizzare efficacemente questa tecnologia di imballaggio avanzata.
Cos'è BGA
BGA è un tipo unico di imballaggio a montaggio superficiale, che viene utilizzato per i circuiti integrati in cui è elettronico componenti dell'SMD sono affissi e montati sulla superficie del circuito stampato SMT. BGA è caratterizzato da cavi a forma di palla che vengono distribuiti in array nella parte inferiore del pacchetto. E la matrice di sfere in realtà prende il nome perché è una matrice di sfere di metallo o lega disposta in una griglia.
Pacchetti BGA vengono utilizzati per montare dispositivi su base permanente. Ha la capacità di fornire più pin di interconnessione in cui è possibile inserire pacchetti piatti o doppi in linea. I perni utilizzati in questa tecnologia sono sfere di saldatura disposte secondo uno schema (di solito un modello a griglia) sulla superficie inferiore della confezione. Questo viene fatto per aumentare l'area per le connessioni anziché solo la periferia. La cosa più interessante, con saldatura BGA, puoi ottenere il vantaggio di utilizzare l'intera superficie inferiore del dispositivo invece di utilizzare solo il perimetro.
Questa è una tecnica che viene utilizzata in vari prodotti elettronici per montare diversi circuiti integrati come FPGA, Chip Wi-Fi, e FPGA, eccetera. Ancora di più, questi pacchetti vengono utilizzati anche nei dispositivi RAM, Chipset per PC, e microcontrollori.
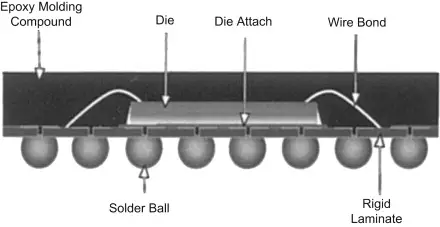
Come funziona la saldatura BGA
Primo, la pasta saldante viene applicata al Piastre PCB dove le sfere di saldatura BGA entreranno in contatto. La pasta saldante viene solitamente erogata attraverso un processo di stencil o serigrafia per garantire un'applicazione accurata e ripetibile.
Poi, il componente BGA è posizionato con precisione e fissato temporaneamente sul PCB. Questo viene fatto utilizzando apparecchiature pick-and-place con sistemi di controllo del movimento X-Y e di allineamento ottico ad alta precisione. Il corretto allineamento è fondamentale.
Poi, il PCBUN viene inviato attraverso un forno di rifusione con un profilo di temperatura definito. La pasta saldante si scioglie, le sfere di saldatura del BGA si sciolgono e si fondono con le piazzole del PCB, formazione dei giunti di saldatura. Il profilo deve essere sufficientemente caldo per rifondere la saldatura senza danneggiare i componenti.
Scorso, dopo il raffreddamento, i giunti di saldatura vengono ispezionati per verificarne la corretta formazione senza difetti. Qualsiasi rilavorazione necessaria viene completata utilizzando apparecchiature e procedure di rilavorazione BGA specializzate.
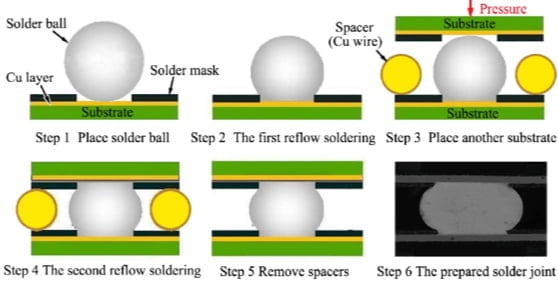
Ispezione dei giunti di saldatura BGA
Quando furono introdotti per la prima volta i pacchetti ball grid array, c'era incertezza su come verificare i giunti di saldatura, poiché non sono visibili sotto il componente. Non è stato possibile utilizzare i metodi tradizionali di ispezione ottica. Anche, i test elettrici mancano di affidabilità poiché riflettono solo la conduttività elettrica del BGA nel momento specifico del test. Questo metodo non riesce ad anticipare la durabilità a lungo termine della saldatura, che nel tempo potrebbero causare guasti al giunto di saldatura.
Per ispezionare veramente i giunti di saldatura BGA, era necessaria una tecnica di imaging a raggi X. I raggi X possono penetrare nel componente e catturare immagini delle giunzioni nascoste. così, L'ispezione a raggi X è diventata essenziale per il controllo del processo e la garanzia della qualità durante l'assemblaggio di schede con BGA. Ispezione a raggi X fornisce la sicurezza necessaria verificando che tutti i giunti siano completamente e correttamente formati. Con i raggi X, i produttori possono convalidare i propri processi BGA e garantire l'affidabilità a lungo termine richiesta da queste interconnessioni nascoste.

Rielaborazione BGA
Quando un componente della griglia a sfere risulta difettoso, è necessario un processo di rilavorazione per rimuoverlo e sostituirlo. I giunti di saldatura devono essere fusi con cura senza disturbare i componenti vicini. Ciò viene ottenuto utilizzando una stazione di rilavorazione BGA, che utilizza calore e flusso d'aria mirati.
Un preriscaldatore a infrarossi riscalda delicatamente la tavola dal basso per ridurre al minimo lo shock termico. Una termocoppia monitora le temperature in tempo reale. Uno strumento a vuoto solleva la confezione BGA una volta rifluita. Controlli rigorosi dei processi sono vitali per il successo:
- Abbina le leghe di saldatura per garantire la compatibilità dei giunti
- Bilanciare la forza adesiva dell'adesivo per le regolazioni di posizionamento
- Seguire attentamente i profili termici prescritti
- Utilizzare l'impostazione minima del flusso d'aria richiesta
- Aumentare lentamente il BGA dopo il riflusso, evitando lo strofinamento
- Selezionare la dimensione dell'ugello corrispondente al componente
Con esperienza e procedure disciplinate, la rielaborazione dei BGA può diventare affidabile. Ma richiede grande precisione e attenzione per evitare danni collaterali. Processi ben calibrati, strumenti specializzati, e l'abilità dell'operatore sono fattori chiave per ottenere risultati di rilavorazione BGA di qualità.
Pensieri finali
Implementazione di una robusta saldatura BGA, ispezione, e i processi di rilavorazione richiedono investimenti in tecniche specializzate, attrezzatura, e formazione degli operatori. Ma i vantaggi del packaging BGA a densità più elevata rendono questo sforzo utile in termini di qualità e prestazioni. Con esperienza nella stampa di precisione, posizionamento accurato, riflusso profilato, ispezione a raggi X, e rilavorazione controllata, produttori come MOKO Technology consentono ai clienti di sfruttare appieno i BGA nelle applicazioni critiche. In qualità di fornitore leader di assemblaggio di PCB con quasi 20 Anni di esperienza, MOKO è specializzata nella tecnologia di saldatura avanzata Ball Grid Array. Contattaci oggi per discutere del tuo particolare progetto BGA e dei requisiti di assemblaggio.